Wire bonding tool bonding wedge
Ipinakikilala ng artikulong ito ang istruktura, materyales, at mga ideya sa pagpili ng karaniwang ginagamit na bonding wedge para sa micro assembly wire bonding. karaniwang kinabibilangan ng paglilinis, pag-sinter ng chip ng device, wire bonding, sealing cap at iba pang proseso. Ang wire bonding ay isang teknolohiya upang mapagtanto ang electrical interconnection at information intercommunication sa pagitan ng chip at substrate. Ang splinter ay naka-install sa wire bonding machine. Sa ilalim ng pagkilos ng panlabas na enerhiya (ultrasoniko, presyon, init), sa pamamagitan ng plastic deformation ng metal at ang solid phase diffusion ng atoms, ang wire (gold wire, gold strip, aluminum wire, aluminum strip, copper wire, copper strip) at nabuo ang bonding pad. Upang makamit ang pagkakabit sa pagitan ng chip at ng circuit, tulad ng ipinapakita sa Figure 1.

1. Bonding wedge structure
Ang pangunahing katawan ng tool sa paghahati ay karaniwang cylindrical, at ang hugis ng ulo ng pamutol ay hugis-wedge. Ang likod ng cutter ay may butas para sa pagtagos sa bonding lead, at ang butas ng aperture ay nauugnay sa wire diameter ng lead na ginamit. Ang dulong mukha ng ulo ng pamutol ay may iba't ibang mga istraktura ayon sa mga pangangailangan ng paggamit, at ang dulong mukha ng ulo ng pamutol ay tumutukoy sa laki at hugis ng pinagsamang panghinang. Kapag ginagamit, ang lead wire ay dumadaan sa opening hole ng splitter at bumubuo ng 30° ~ 60° Angle sa pagitan ng lead wire at ng pahalang na eroplano ng bonding area. Kapag bumagsak ang splitter sa bonding area, pipindutin ng splitter ang lead wire sa bonding area upang bumuo ng shovel o horseshoe solder joint. Ang ilang Bonding wedge ay ipinapakita sa Figure 2.

2. Bonding wedge material
Sa panahon ng proseso ng pag-bonding, ang mga bonding wire na dumadaan sa bongding wedege ay bumubuo ng pressure at friction sa pagitan ng cleaver head at ng solder pad metal. Samakatuwid, ang mga materyales na may mataas na tigas at tigas ay karaniwang ginagamit upang gumawa ng mga cleaver. Ang pagsasama-sama ng mga kinakailangan ng mga pamamaraan ng pagpuputol at pagbubuklod, kinakailangan na ang materyal ng pagpuputol ay may mataas na density, mataas na lakas ng baluktot, at maaaring magproseso ng makinis na ibabaw. Kasama sa mga karaniwang cutting materials ang tungsten carbide (hard alloy), titanium carbide, at ceramics.
Ang tungsten carbide ay may malakas na resistensya sa pinsala at malawakang ginagamit sa paggawa ng mga tool sa paggupit sa mga unang araw. Gayunpaman, ang machining ng tungsten carbide ay medyo mahirap, at hindi madaling makakuha ng isang siksik at walang butas na ibabaw ng pagproseso. Ang Tungsten carbide ay may mataas na thermal conductivity. Upang maiwasan ang init sa solder pad na madala ng cutting edge sa panahon ng proseso ng bonding, ang tungsten carbide cutting edge ay dapat na pinainit sa panahon ng proseso ng bonding.
Ang materyal na density ng titanium carbide ay mas mababa kaysa sa tungsten carbide, at ito ay mas nababaluktot kaysa sa tungsten carbide. Kapag gumagamit ng parehong ultrasonic transducer at ang parehong istraktura ng blade, ang amplitude ng blade na nabuo ng ultrasonic wave na ipinadala sa titanium carbide blade ay 20% na mas malaki kaysa sa tungsten carbide blade.
Sa mga nagdaang taon, ang mga keramika ay malawakang ginagamit sa paggawa ng mga tool sa pagputol dahil sa kanilang mahusay na mga katangian ng kinis, density, walang mga pores, at matatag na mga katangian ng kemikal. Ang dulo ng mukha at butas na pagproseso ng mga ceramic cleaver ay mas mahusay kaysa sa mga tungsten carbide. Bilang karagdagan, ang thermal conductivity ng ceramic cleave ay mababa, at ang cleave mismo ay maaaring iwanang hindi pinainit.
3. Bonding wedge selection
Tinutukoy ng pagpili ang kalidad ng pagbubuklod ng lead wire. Ang mga salik gaya ng laki ng bonding pad, bonding pad spacing, welding depth, lead diameter at hardness, welding speed at accuracy ay dapat isaalang-alang nang komprehensibo. Ang mga wedge split ay karaniwang 1/16inch (1.58mm) ang diameter at nahahati sa solid at hollow split. Karamihan sa mga wedge split ay nagpapakain sa wire sa ilalim ng cutter sa isang 30°, 45°, o 60° feed Angle. Pinipili ang mga hollow splitter para sa mga deep cavity na produkto, at ang Wire ay patayong ipinapasa sa hollow wedge splitter, tulad ng ipinapakita sa Figure 3. Ang mga solid cleaver ay kadalasang pinipili para sa mass production dahil sa kanilang mabilis na Bond rate at mataas na solder joint consistency. Pinipili ang mga hollow split para sa kanilang kakayahang mag-bond ng mga deep cavity na produkto, at ang pagkakaiba sa pagbubuklod na may solid split ay ipinapakita sa Figure 3.
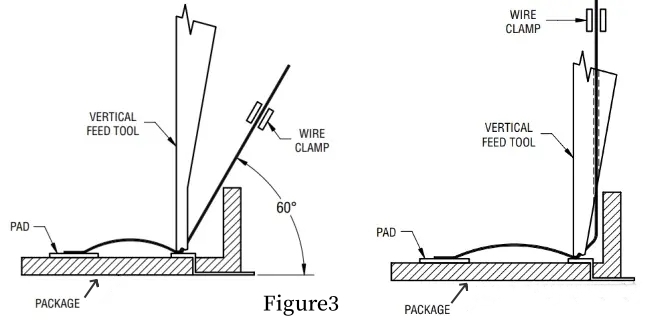
Tulad ng makikita mula sa figure 3, kapag nagbubuklod sa isang malalim na lukab o mayroong isang gilid na dingding, ang Wire ng solid split na kutsilyo ay madaling hawakan ang gilid na dingding, na nagiging sanhi ng isang nakatagong Bond. Maaaring maiwasan ng hollow split knife ang problemang ito. Gayunpaman, kumpara sa solid split knife, hollow split knife ay mayroon ding ilang mga pagkukulang, tulad ng mababang bonding rate, mahirap kontrolin ang consistency ng solder joint, at mahirap kontrolin ang consistency ng tail wire.
Ang istraktura ng dulo ng Bonding wedge ay ipinapakita sa Figure 4.
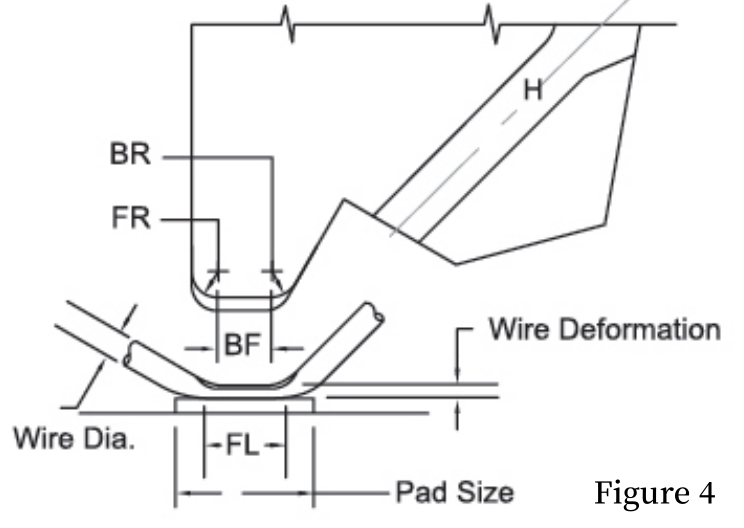
Diameter ng Hole(H):Tinutukoy ng aperture kung ang linya ng pagbubuklod ay maaaring dumaan sa cutter ng maayos. Kung ang panloob na aperture ay masyadong malaki, ang bonding point ay ma-offset o LOOP offset, at maging ang solder joint deformation ay abnormal. Ang panloob na aperture ay masyadong maliit, ang bonding line at ang panloob na pader ng splitter friction, na nagreresulta sa pagkasira, binabawasan ang kalidad ng bonding. Dahil ang bonding wire ay may wire feeding Angle, ang agwat sa pagitan ng butas ng bonding wire at ang split knife sa pangkalahatan ay dapat na higit sa 10μm upang matiyak na walang friction o resistance sa panahon ng proseso ng wire feeding.
Front Radius (FR): Ang FR ay karaniwang hindi nakakaapekto sa unang bono, pangunahing nagbibigay ng proseso ng LOOP, para sa pangalawang paglipat ng bono, upang mapadali ang pagbuo ng arko ng linya. Ang masyadong maliit na pagpili ng FR ay magpapataas ng crack o crack ng pangalawang welding root. Sa pangkalahatan, ang pagpili ng laki ng FR ay kapareho ng o bahagyang mas malaki kaysa sa diameter ng wire; Para sa gintong wire, maaaring piliin ang FR na mas mababa sa diameter ng wire.
Back Radius (BR): Ang BR ay pangunahing ginagamit upang i-transition ang unang bono sa panahon ng proseso ng LOOP, na pinapadali ang pagbuo ng arko ng unang linya ng bono. Pangalawa, pinapadali nito ang pagkasira ng wire. Ang pagpili ng BR ay nakakatulong na mapanatili ang pagkakapare-pareho sa pagbuo ng mga tail wire sa panahon ng proseso ng pagkabasag ng wire, na kapaki-pakinabang para sa tail wire control at iniiwasan ang mga short circuit na dulot ng long tail wires, pati na rin ang mahinang deformation ng solder joint na dulot ng maikling buntot. mga wire. Sa pangkalahatan, ang gintong wire ay gumagamit ng isang mas maliit na BR upang makatulong na putulin ang wire na malinis. Kung masyadong maliit ang napiling BR, madaling magdulot ng mga bitak o bali sa ugat ng isang solder joint; Ang labis na pagpili ay maaaring magresulta sa hindi kumpletong pagkasira ng wire sa proseso ng hinang. Ang pagpili ng laki ng pangkalahatang BR ay kapareho ng diameter ng wire; Para sa gintong wire, maaaring piliin ng BR na mas maliit kaysa sa diameter ng wire.
Bond Flat(BF):Ang pagpili ng BF ay depende sa Wire Diameter at Pad Size. Ayon sa GJB548C, ang haba ng wedge weld ay dapat nasa pagitan ng 1.5 at 6 na beses kaysa sa Wire Diameter, dahil ang masyadong maiikling mga key ay madaling makakaapekto sa lakas ng bonding o maaaring hindi secure ang bond. Samakatuwid, ito ay karaniwang kailangang 1.5 beses na mas malaki kaysa sa Wire Diameter, at ang haba ay hindi dapat lumampas sa Pad Size o 6 na beses na mas mahaba kaysa sa Wire Diameter.
Haba ng Bond(BL):Ang BL ay pangunahing binubuo ng FR, BF at BR gaya ng ipinapakita sa Figure 4. Samakatuwid, kapag masyadong maliit ang Pad Size, dapat nating bigyang pansin kung ang Sukat ng FR, BF at BR ng splitting knife ay nasa loob ng Pad Size upang maiwasang lumampas sa Pad solder joint. Karaniwang BL=BF+1/3FR+1/3BR.
4.Ibuod
Bonding wedge ay isang mahalagang kasangkapan para sa microassembly lead bonding. Sa larangan ng sibil, ang lead bonding ay pangunahing ginagamit sa chip, memory, flash memory, sensor, consumer electronics, automotive electronics, power device at iba pang industriya. Sa larangan ng militar, ang lead bonding ay pangunahing ginagamit sa RF chips, filters, missile seeker, armas at kagamitan, electronic information countermeasures system, spaceborne phased array radar T/R component, military electronics, aerospace, aviation at mga industriya ng komunikasyon. Sa papel na ito, ipinakilala ang materyal, istraktura at ideya sa pagpili ng karaniwang Bonding wedge, na makakatulong sa mga user na pumili ng pinaka-angkop na wedge split, upang makakuha ng magandang kalidad ng welding at mabawasan ang gastos.