Wire bonding tool bonding wedge
Kini nga artikulo nagpaila sa istruktura, mga materyales, ug mga ideya sa pagpili sa sagad nga gigamit nga bonding wedge alang sa micro assembly wire bonding. kasagaran naglakip sa pagpanglimpyo, device chip sintering, wire bonding, sealing cap ug uban pang mga proseso. Ang wire bonding usa ka teknolohiya aron maamgohan ang electrical interconnection ug information intercommunication tali sa chip ug substrate. Ang splinter gibutang sa wire bonding machine. Ubos sa aksyon sa gawas nga enerhiya (ultrasonic, pressure, kainit), pinaagi sa plastik nga deformation sa metal ug ang solid phase diffusion sa mga atomo, ang wire (bulawan nga wire, bulawan nga strip, aluminum wire, aluminum strip, tumbaga wire, tumbaga strip) ug naporma ang bonding pad. Aron makab-ot ang interkoneksyon tali sa chip ug sa sirkito, ingon sa gipakita sa Figure 1.

1. Pagdugtong sa wedge structure
Ang nag-unang lawas sa himan sa pagbahin kasagaran cylindrical, ug ang porma sa ulo sa cutter kay wedge-shaped. Ang likod sa cutter adunay usa ka lungag alang sa paglusot sa bonding lead, ug ang lungag aperture nalangkit sa wire diameter sa lead nga gigamit. Ang katapusan nga nawong sa ulo sa cutter adunay lainlaing mga istruktura sumala sa mga panginahanglanon sa paggamit, ug ang katapusan nga nawong sa ulo sa pamutol nagtino sa gidak-on ug porma sa hiniusa nga solder. Kung gigamit, ang lead wire moagi sa pag-abli sa lungag sa splitter ug maporma ang 30 ° ~ 60 ° Anggulo tali sa lead wire ug sa pinahigda nga eroplano sa bonding area. Sa diha nga ang splitter mahulog ngadto sa bonding area, ang splitter mopilit sa lead wire sa bonding area aron mahimong usa ka pala o horseshoe solder joint. Ang ubang mga bonding wedge gipakita sa Figure 2.

2. Pagbugkos nga wedge nga materyal
Atol sa proseso sa pagtrabaho sa bonding, ang mga bonding wire nga moagi sa bongding wedege makamugna og pressure ug friction tali sa cleaver head ug sa solder pad metal. Busa, ang mga materyales nga adunay taas nga katig-a ug katig-a kasagarang gigamit sa paghimo sa mga cleaver. Ang paghiusa sa mga kinahanglanon sa pagputol ug mga pamaagi sa pagbugkos, gikinahanglan nga ang chopping nga materyal adunay taas nga densidad, taas nga kusog sa bending, ug makaproseso sa usa ka hapsay nga nawong. Ang kasagarang mga materyales sa pagputol naglakip sa tungsten carbide (gahi nga haluang metal), titanium carbide, ug seramiko.
Ang Tungsten carbide adunay lig-on nga pagbatok sa kadaot ug kaylap nga gigamit sa paghimo sa mga himan sa pagputol sa unang mga adlaw. Bisan pa, ang machining sa tungsten carbide medyo lisud, ug dili sayon ang pagkuha sa usa ka dasok ug pore nga libre nga pagproseso nga nawong. Ang tungsten carbide adunay taas nga thermal conductivity. Aron malikayan ang kainit sa solder pad nga madala sa cutting edge sa panahon sa proseso sa bonding, ang tungsten carbide cutting edge kinahanglan nga ipainit sa panahon sa proseso sa bonding.
Ang materyal nga Densidad sa titanium carbide mas ubos kay sa tungsten carbide, ug kini mas flexible kay sa tungsten carbide. Kung gigamit ang parehas nga ultrasonic transducer ug parehas nga istruktura sa blade, ang amplitude sa blade nga namugna sa ultrasonic wave nga gipasa sa titanium carbide blade mao ang 20% nga mas dako kaysa sa tungsten carbide blade.
Sa bag-ohay nga mga tuig, ang mga seramika kaylap nga gigamit sa paghimo sa mga himan sa pagputol tungod sa ilang maayo kaayo nga mga kinaiya sa pagkahapsay, densidad, walay mga pores, ug lig-on nga kemikal nga mga kabtangan. Ang katapusan nga nawong ug pagproseso sa lungag sa mga ceramic cleavers mas maayo kaysa sa tungsten carbide. Dugang pa, ang thermal conductivity sa mga ceramic cleave ubos, ug ang cleave mismo mahimong dili mapainit.
3. Pagpili sa wedge sa bonding
Ang pagpili nagtino sa kalidad sa pagbugkos sa lead wire. Ang mga hinungdan sama sa gidak-on sa bonding pad, gilay-on sa bonding pad, giladmon sa welding, diyametro sa lead ug katig-a, katulin ug katukma sa welding kinahanglan nga konsiderahon nga komprehensibo. Ang mga wedge split kasagarang 1/16inch (1.58mm) ang diyametro ug gibahin sa solid ug hollow split. Kadaghanan sa wedge split nagpakaon sa wire ngadto sa ubos sa cutter sa 30°, 45°, o 60° feed Angle. Ang mga hollow splitter gipili alang sa lawom nga mga produkto sa lungag, ug ang Wire gipasa sa vertically pinaagi sa hollow wedge splitter, ingon sa gipakita sa Figure 3. Ang mga solid cleaver kasagarang gipili alang sa mass production tungod sa ilang paspas nga Bond rate ug taas nga solder joint consistency. Gipili ang mga hollow split alang sa ilang abilidad sa pagbugkos sa lawom nga mga produkto sa lungag, ug ang kalainan sa pagbugkos nga adunay solidong mga split gipakita sa Figure 3.
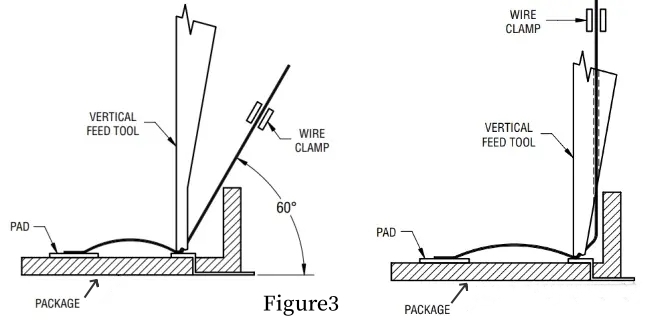
Ingon sa makita gikan sa numero 3, sa diha nga ang pagbugkos sa usa ka lawom nga lungag o adunay usa ka kilid nga bungbong, ang Wire sa solid nga split kutsilyo dali nga makahikap sa kilid nga bungbong, hinungdan sa usa ka tinago nga Bond. Ang hollow split knife makalikay niini nga problema. Bisan pa, kung itandi sa solid split knife, ang hollow split knife usab adunay pipila ka mga kakulangan, sama sa ubos nga bonding rate, lisud nga kontrolon ang pagkamakanunayon sa solder joint, ug lisud nga kontrolon ang pagkamakanunayon sa tail wire.
Ang tumoy nga istruktura sa Bonding wedge gipakita sa Figure 4.
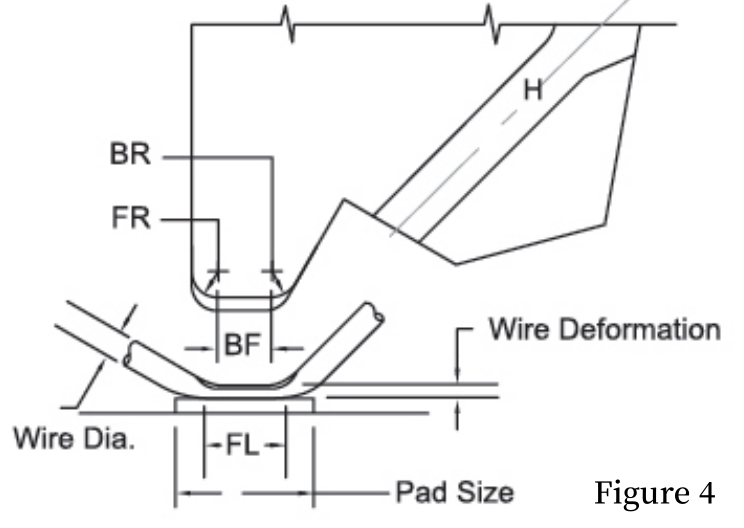
Diametro sa Hole(H):Ang aperture nagtino kung ang linya sa pagbugkos makaagi ba sa cutter nga hapsay. Kung ang sulod nga aperture dako kaayo, ang bonding point ma-offset o LOOP offset, ug bisan ang solder joint deformation abnormal. Ang sulod nga aperture gamay ra kaayo, ang bonding line ug ang sulod nga bungbong sa splitter friction, nga miresulta sa pagsul-ob, pagkunhod sa kalidad sa bonding. Tungod kay ang bonding wire adunay usa ka wire feeding Angle, ang gintang tali sa lungag sa bonding wire ug ang split knife kinahanglan kasagaran nga mas dako pa kay sa 10μm aron masiguro nga walay friction o pagsukol sa panahon sa wire feeding process.
Front Radius (FR): Ang FR sa panguna dili makaapekto sa una nga bugkos, nag-una nga naghatag sa proseso sa LOOP, alang sa ikaduha nga pagbalhin sa bugkos, aron mapadali ang pagporma sa arko sa linya. Ang gamay ra kaayo nga pagpili sa FR makadugang sa crack o cracking sa ikaduhang welding root. Sa kinatibuk-an, ang gidak-on sa pagpili sa FR mao ang sama sa o gamay nga mas dako pa kay sa wire diametro; Alang sa bulawan nga alambre, ang FR mahimong mapili nga mas ubos kaysa sa diametro sa wire.
Balik Radius (BR): Ang BR kasagaran gigamit sa pagbalhin sa unang bugkos sa panahon sa proseso sa LOOP, pagpasayon sa arko sa pagporma sa unang linya sa bugkos. Ikaduha, kini nagpadali sa pagkaguba sa wire. Ang pagpili sa BR makatabang sa pagpadayon sa pagkamakanunayon sa pagporma sa mga wire sa ikog sa panahon sa proseso sa pagkaguba sa wire, nga mapuslanon alang sa pagkontrol sa tail wire ug paglikay sa mga short circuit tungod sa taas nga mga wire sa ikog, ingon man ang dili maayo nga deformation sa usa ka solder joint tungod sa mubo nga ikog. mga alambre. Sa kinatibuk-an, ang bulawan nga alambre naggamit ug mas gamay nga BR aron makatabang sa pagputol sa alambre nga limpyo. Kung gipili ang BR nga gamay ra, dali nga hinungdan sa mga liki o pagkabali sa gamut sa usa ka solder joint; Ang sobra nga pagpili mahimong moresulta sa dili kompleto nga pagkaguba sa wire sa proseso sa welding. Ang gidak-on nga pagpili sa kinatibuk-ang BR mao ang sama sa wire diametro; Para sa bulawan nga alambre, BR makapili nga mas gamay kay sa wire diameter.
Bond Flat(BF):Ang pagpili sa BF nagdepende sa Wire Diameter ug Pad Size. Sumala sa GJB548C, ang gitas-on sa wedge weld kinahanglan nga tali sa 1.5 ug 6 nga mga panahon sa Wire Diameter, tungod kay ang mubo nga mga yawe dali nga makaapekto sa kusog sa pagbugkos o ang bugkos mahimong dili luwas. Busa, kini sa kasagaran kinahanglan nga 1.5 ka beses nga mas dako kay sa Wire Diameter, ug ang gitas-on kinahanglan nga dili molapas sa Pad Size o 6 ka beses nga mas taas kay sa Wire Diameter.
Gitas-on sa Bond (BL):Ang BL kasagaran gilangkuban sa FR, BF ug BR sama sa gipakita sa Figure 4. Busa, kung gamay ra kaayo ang Pad Size, kinahanglan natong hatagan ug pagtagad kung ang Size sa FR, BF ug BR sa splitting knife. naa sa sulod sa Pad Size aron malikayan ang pagsobra sa Pad solder joint. Kasagaran BL=BF+1/3FR+1/3BR.
4. I-summarize
Bonding wedge usa ka importante nga himan alang sa microassembly lead bonding. Sa sibil nga natad, ang lead bonding kay gigamit sa chip, memory, flash memory, sensor, consumer electronics, automotive electronics, power devices ug uban pang industriya. Sa natad sa militar, ang lead bonding kasagarang gigamit sa RF chips, filters, missile seeker, armas ug kagamitan, electronic information countermeasures system, spaceborne phased array radar T/R components, military electronics, aerospace, aviation ug komunikasyon nga industriya. Niini nga papel, ang materyal, istruktura ug pagpili nga ideya sa komon nga Bonding wedge gipaila, nga makatabang sa pagtabang sa mga tiggamit sa pagpili sa labing angay nga wedge splits, aron makakuha og maayo nga kalidad sa welding ug makunhuran ang gasto.